New Modelling Off-state TDDB for 130nm to 28nm CMOS nodes
Résumé
We present a detailed analysis of Off-state Time Dependent Dielectric Breakdown (TDDB) under non-uniform field performed in MOSFET devices from 28nm FDSOI, 65nm SOI to 130nm nodes. Oxide breakdown in thin gate oxide is characterized under DC stress with different gate-length LG and as function of drain voltage VDS and temperature. We show that the leakage current is a better monitor for TDDB dependence under Off-mode stress whereas a new modeling is proposed. It is found that Weibull slopes β are higher in PFET due large amount of injected hot electrons than in NFET when hot holes are involved.
Domaines
Sciences de l'ingénieur [physics]
Fichier principal
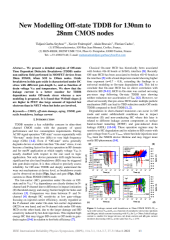 Paper IRPS 2022_GARBA SEYBOU Tidjani - TDDB OFF STATE - Final.pdf (674.92 Ko)
Télécharger le fichier
Paper IRPS 2022_GARBA SEYBOU Tidjani - TDDB OFF STATE - Final.pdf (674.92 Ko)
Télécharger le fichier
| Origine | Fichiers produits par l'(les) auteur(s) |
|---|